博文
电子封装可靠性测试需要做哪些测试?
||
1、概述
在芯片完成整个封装流程之后,封装厂会对其产品进行质量和可靠性两方面的检测。
质量检测主要检测封装后芯片的可用性,封装后的质量和性能情况,而可靠性则是对封装的可靠性相关参数的测试。
首先,我们必须理解什么叫做“可靠性”,产品的可靠性即产品可靠度的性能,具体表现在产品使用时是否容易出故障,产品使用寿命是否合理等。如果说“品质”是检测产品“现在”的质量的话,那么“可靠性”就是检测产品“未来”的质量。
图(1)所示的统计学上的浴盆曲线(Bathtub Curve)很清晰地描述了生产厂商对产品可靠性的控制,也同步描述了客户对可靠性的需求。
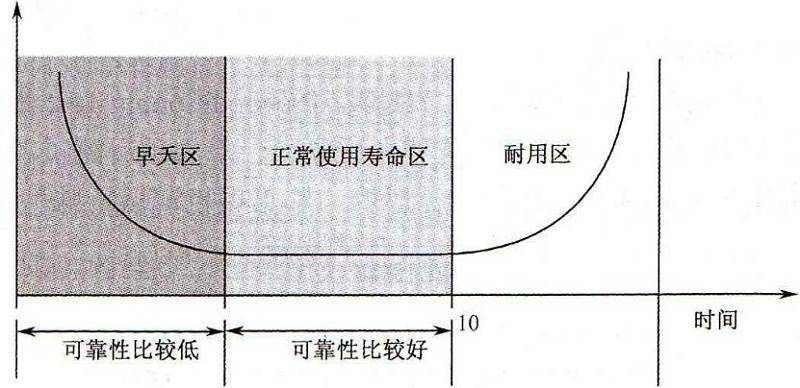
上图所示的早夭区是指短时间内就会被损坏的产品,也是生产厂商需要淘汰的,客户所不能接受的产品;正常使用寿命区代表客户可以接受的产品;耐用区指性能特别好,特别耐用的产品。由图上的浴缸曲线可见,在早天区和耐用区,产品的不良率一般比较高。在正常使用区,才有比较稳定的良率。大部分产品都是在正常使用区的。可靠性测试就是为了分辨产品是否属于正常使用区的测试,解决皁期开发中产品不稳定,良率低等问题,提高技术,使封装生产线达到高良率,稳定运行的自的。
在封装业的发展史上,早期的封装厂商并不把可靠性测试放在第一位,人们最先重视的是产能,只要一定生产能力就能赢利。到了90年代,随着封装技术的发展,封装厂家也逐渐增多,产品质量就摆到了重要位置,谁家产品的质量好,就占绝对优势,于是质量问题是主要的竟争点和研究方向。进入21世纪,当质量问题基本解决以后,广厂商之间的竞争重点放在了可靠性上,同等质量,消费者自然喜欢高可靠性的产品,于是可靠性越发显示其重要性,高可靠性是现代封装技术的研发的重要指标。
2、可靠性测试项目
一般封装厂的可靠性测试项目有6项,如表1所示

各个测试项都有一定的目的,针对性和具体方法,但就测试项目而言,基本上都与温度,湿度,压强等环境参数有关,偶尔还会加上偏压等以制造恶劣破坏环境来达到测试产品可靠性的自的。
各个测试项目大都采用采样的方法,即随机抽查一定数量产品的可靠性测试结果来断定生产线是否通过可靠性测试。各个封装厂的可靠性判定标准也各不相同,实力雄厚的企业一般会用较高水准的可靠性标准。
6种测试项目是有先后顺序的,如图(2)所示。Preconditioning Test是首先要进行的测试项目,之后进行其他5项的测试。之所以有这种先后顺序,是由PRECON TEST的目的决定的,在以下的章节中,我们分别讲述各种测试的具体内容,目的。鉴于PRECON TEST特殊性,将放在最后介绍。

3、T/C测试(温度循环测试)
T/C (Temperature Cycling)测试,即温度循环测试。
温度循环试验箱如图3所示,由一个热气腔,一个冷气腔组成,腔内分别填充着热冷空气(热冷空气的温度各个封装厂有自己的标准,相对温差越大,通过测试的产品的某特性可靠性越高)。两腔之间有个阀门,是待测品往返两腔的通道。
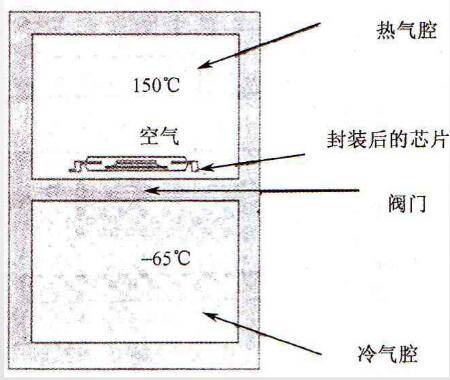
在封装芯片做T/C测试的时候,有4个参数,分别为热腔温度,冷腔温度,循环次数,芯片单次单腔停留时间。

如表2所示的参数就代表T/C测试时把封装后的芯片放在150℃的温度循环试验箱15分钟,再通过阀门放入-65℃的低温箱15分钟,再放入高温箱,如此反复1000次。之后测试电路性能以检测是否通过T/C可靠性测试。
从T/C的测试方法已经可以看出,T/C测试得主要目的是测试半导体封装体热胀冷缩的耐久性。
在封装体中,有许多种材料,材料之间都有相应的结合面,在封装体所处环境的温度有所变化时,封装体内各种材料就会有热胀冷缩效应,而且材料热膨胀系数不同,其热胀冷缩的程度就有所不同,这样原来紧密结合的材料结合面就会出现问题。图示4是以Lead frame封装为例,热胀冷缩是的具体情况:其中主要的材料包括lead frame的Cu材料,芯片的硅材料,连接用的金线材料,还有芯片粘接的胶体材料。其中EMC与硅芯片,Lead frame有大面积基础,比较容易脱层,硅芯片与粘合的硅胶,硅胶和leadframe之间也会在T/C测试中失效。
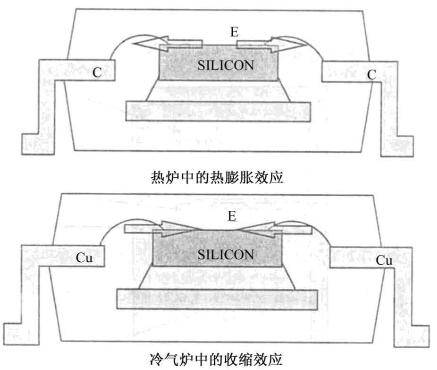
再由图5来看一下T/C测试中的几个失效模型。

4、T/S测试(冷热冲击测试)
T/S test (Thermal Shock test)即测试封装体抗热冲击的能力。
T/S测试和T/C测试有点类似,不同的是T/S测试环境是在高温液体中转换,液体的导热比空气快,于是有较强的热冲击力。

例如表3所示的参数,就代表在2个隔离的区域分别放入150℃的液体和-65℃的液体,然后把封装产品放入一个区,5分钟后再装入另一个区,由于温差大,传热环境好,封装体就受到很强的热冲击,如此往复1000次,来测试产品的抗热冲击性,最终也是通过测试电路的通断情况断定产品是否TS可靠性测试。

5、HTS测试
HTS (High temperature Storage)测试,是测试封装体长时间暴露在高温环境下的耐久性实验。
HTS测试是把封装产品长时间放置在高温氮气烤箱中,然后测试它的电路通断情况。


如表4参数表示封装放置在150℃高温氮气烤箱中1000小时(图7中)。
HTS测试的重点是因为在高温条件下,半导体构成物质的活化性增强,会有物质间的扩散作用,而导致电气的不良发生,另外因为高温,机械性较弱的物质也容易损坏。
例如图8所示的kirkendall孔洞产生就是因为物质可扩散作用造成的。
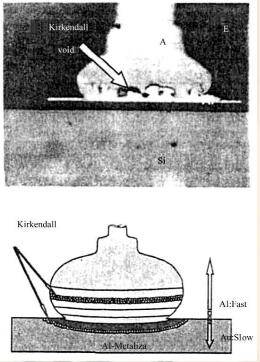
在金线和芯片的结合面上,它的材料结构依次为:铝,铝金合金,金,在高温的状态下,金和铝金属都变得很活跃,相互会扩散,但是由于铝的扩散速度比金要快,所以在铝的界面物质就变少,就形成了孔洞。这样就造成电路性能不好,甚至导致断路。
那么如何解决HTS可靠性测试不良的问题呢?
首先在特定情况下,我们可以选择使用同种物质结合电路,比如军事上,金线用铝线代替,这样就不会因为金属间的扩散而产生不良了。
我们也可以用掺杂物质作中介层来抑制物质间的相互扩散。当然还有一种方法就是避免把封装体长时间在高温下放置,没有长时间的高温环境,自然不会有扩散导致失效的结果了。
6、TH测试
TH (Temperature & Humidity)测试,是测试封装在高温潮湿环境下的耐久性的实验

实验结束时也是靠测定封装体电路的通断特性来断定产品是否有优良的耐高温湿性。
在TH测试中,由于EMC材料有一定的吸湿性,而内部电路在潮湿的环境下,很容易导致漏电,短路等效应。
为了有更好的防湿性,我们会选择使用陶瓷封装来代替塑料封装,因为塑料封装的EMC材料比较容易吸水。当然也可控制EMC的材料成分,以达到改善其吸湿性的目的。
如图9所示,TH测试是在一个能保持恒定温度和适度的恒温恒湿试验箱中进行的,一般测试参数如表5

7、PCT测试
PCT (Pressure Cooker Test),是对封装体抵抗抗潮湿环境能力的测试。PCT测试与TH测试类似,只是增加了压强环境以缩短测试时间,通常做PCT测试的工具我们叫“高压锅、高压加速老化试验箱”。

PCT测试的参数如表6所示:

在PCT测试最后,也同样是测试产品的电路通断性能。在Leadframe封装中,Leadframe材料和EMC材料结合处很容易水分渗入,这样就容易腐蚀内部的电路,腐蚀铝而破坏产品功能。这种情况,一般建议用UV光来照射产品检测Leadframe材料和EMC材料结合情况。
PCT针对性的解决方法就是提高Leadframe和EMC之间的结合力度,我们可以调节EMC材料成分,也可以针对性地处理Leadframe的表面。
8、Precon测试
Precon测试,即Pre-conditioning测试。从集成电路芯片封装完成以后到实际再组装,这个产品还有很长一段过程,这个过程包括包装、运输等,这些都会损坏产品,所以我们就需要先模拟这个过程,测试产品的可靠性。这就是Precon测试。其实在Precon测试中,包括了前面的T/IC,TH等多项测试的组合。
Precon测试模拟的过程如下图所示:
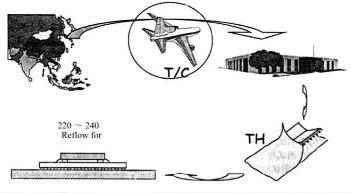
产品完成封装后需要包装好,运输到组装厂,然后拆开包装把封装后芯片组装在下一级板子上,并且组装还要经过焊锡的过程,整个过程既有类似TC的经过,也有类似TH的过程,焊锡过程也需要模拟测试。
整个Precon测试有一定的测试流程,测试前检查电气性能和内部结构(用超声波检测),确定没有问题,开始各项恶劣环境的考验,先是T/C测试模拟运输过程中的温度变化,再模拟水分子干燥过程(一般的包装都是真空包装,类似于水分干燥),然后恒温,定时放置一段时间(随着参数的不同,分为6个等级,用于模拟开封后吸湿的过程),最后模拟焊锡过程后再检查电气特性和内部结构。
模拟吸湿过程的6个等级如表7所示,1的等级最高,依次下降,看需要选择等级。

在Precon测试中,会出现的问题有:爆米花效应,脱层,电路失效等问题。这些问题都是因为封装体会在吸湿后再遭遇高温而造成的,高温时,封装体内的水分变为气体从而体积急剧膨胀,造成对封装体的破坏。我们应该减弱EMC的吸湿性解决爆米花效应,减少封装的热膨胀系数,增强附着能力来改善脱层问题,防止电路失效发生。
只有在顺利通过了Precon测试以后,才能保证产品能顺利送到最终用户端,这就是Precon被放在第一个测试位置的原因所在。
终上所述,一个好的封装要有好的可靠性能,必须有较强的耐湿,耐热,耐高温的能力,6个可靠性测试都逃不脱温度,湿度这些内容。我们通过可靠性测试能够评估产品的可靠度,有利于回馈来改善封装设计工艺,从而提高产品的可靠度。




https://blog.sciencenet.cn/blog-2533479-1273518.html
上一篇:5G通用模组需要做哪些温湿度可靠性测试?
下一篇:温度老化的试验方法有哪些?
全部作者的精选博文
- • 创业那些年,创业那些事
- • 该不该去支教?